AZ 10XT Photoresist (520cP) - 3.785 l
Description
Product information "AZ 10XT Photoresist (520cP) - 3.785 l"
AZ® 10XT (520CPS)
Thick photoresist for high resolution
General Information
AZ® 10XT is an i- and h-line (not g- line !) sensitive positive thick photoresist, as the successor to the AZ® 9260 and is largely identical in construction, but with a different surfactant. In contrast to the similarly named AZ® 12XT, the AZ® 10XT is not chemically amplified.
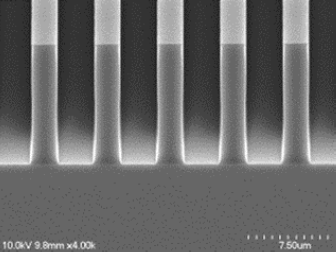
3.0 µm lines in 12 µm thick AZ® 10XT Ultratech 1500 Exposure, AZ® 400K Developer 1:4 (260s spray)
Product Features
AZ® 10XT not only has optimized resist adhesion to common substrate materials, but also the potential for very steep resist sidewalls and high aspect ratios. Accordingly, the AZ® 10XT is often used in electroplating, ion implantation or dry etching/RIE. AZ® 10XT achieves a resist film thickness of approx. 6 µm at a spin speed of 4000 rpm; with an appropriately adjusted spin profile, the resist film thickness range of approx. 4.5 - 20 µm can be covered. If thinner resist layers are desired, the AZ® 10XT can be diluted with PGMEA; alternatively, the thinner AZ® 4533 can also be used for many applications. From a resist film thickness of approximately 10 - 15 µm, processing the AZ® 10XT becomes increasingly time-consuming: the soft bake and subsequent development take longer, more and more time is needed for rehydration between soft bake and exposure, and the risk of nitrogen bubbles forming during exposure increases. For resist film thicknesses greater than 10 µm, it is recommended to consider using a chemically amplified thick resist such as AZ® 12 XT (5 - 20 µm resist film thickness) or AZ®IPS 6090 (> 20 µm resist film thickness), which have significantly shorter soft bake and development times for the corresponding resist thickness, do not need rehydration, require significantly lower exposure doses, and do not release nitrogen during exposure.
Developers
For development, we recommend either TMAH-based developers such as the ready-to-use AZ® 326 MIF or AZ® 726 MIF, or the KOH-based AZ® 400K 1:4 (typically 1: 4 diluted with water, for faster development also slightly stronger with 1:3.5 or 1:3). On alkaline-sensitive substrate materials such as aluminum, we recommend the aluminum-compatible, undiluted AZ® Developer.
Removers
If the resist structures have not been thermally cross-linked by plasma processes, ion implantation or high temperatures (> approx. 140 °C), all common removers such as AZ® 100 Remover, DMSO or many other organic solvents (e.g. Acetone rinsed with Isopropanol) are suitable for removing the resist layer. For cross-linked resist structures, high-performance strippers such as the NMP-free TechniStrip P1316 or AZ® 920 Remover are recommended, and in the case of alkaline-sensitive substrate materials (such as aluminum), the TechniStrip MLO 07.
Thinning / Edge Wall Removal
If the resist is to be diluted for spin coating, PGMEA = AZ® EBR Solvent is the recommended solvent. PGMEA is the solvent for AZ® 10 XT anyway and is also recommended for edge wall removal if necessary.
Further Information
Our safety data sheets and some of our technical data sheets are password-protected.
You will receive the access data after completing the form.
The access data for the data sheets are not your login data from our shop!
MSDS:
Safety Data Sheet AZ® 10XT (520cps) english
Safety Data Sheet AZ® 10XT (520cps) german
TDS:
Technical Data Sheet AZ® 10XT (520cps) english
Anwendungshinweis:
Further Information about Photoresist Processing
Related products
Developer
Remover



































